Kiểm Tra C-SAM (Scanning Acoustic Microscopy): Phát Hiện Khuyết Tật Ẩn Trong Linh Kiện Điện Tử
kiểm tra C-SAM (Scanning Acoustic Microscopy) giúp phát hiện tách lớp, lỗ rỗng, nứt vỡ trong linh kiện điện tử mà X-ray không thấy được. Phù hợp kiểm tra IC, BGA, wafer, PCB, tụ điện. Đạt chuẩn MIL-STD-883 và JEDEC J-STD-020E.
SAT
10/30/20254 phút đọc
Các khuyết tật bên trong (không nhìn thấy được) do quá trình chế tạo hoặc vật liệu có thể gây ảnh hưởng nghiêm trọng đến hiệu suất của các linh kiện vi điện tử đã được đóng gói. Hơn nữa, các lỗi cấu trúc (thiếu bộ phận) hoặc hàng giả cũng là những vấn đề không nhỏ trong thị trường EEE hiện tại. Do đó, các công cụ kiểm tra không phá hủy (non-destructive) đáng tin cậy là rất cần thiết để xác định và sàng lọc các khuyết tật bên trong này. Tuy nhiên, việc kiểm tra trở nên thách thức hơn với sự phức tạp và thu nhỏ ngày càng tăng của các cụm lắp ráp EEE hiện đại, như chip-scale packages và các chồng mạch tích hợp 3D. Trong bối cảnh đó, Kính hiển vi âm học quét (Scanning Acoustic Microscopy - SAM, hay C-SAM) nổi lên như một trong những phương pháp được ưa chuộng nhất.
C-SAM Là Gì và Hoạt Động Như Thế Nào?
C-SAM là một kỹ thuật kiểm tra không phá hủy sử dụng sóng siêu âm tần số cao để tạo ra hình ảnh bên trong vật liệu. Nó hoạt động dựa trên nguyên tắc: sóng siêu âm sẽ phản xạ hoặc truyền qua khác nhau khi gặp sự thay đổi về vật liệu hoặc mật độ.
Điểm mạnh: Kỹ thuật âm học đặc biệt phù hợp để phát hiện các bất thường liên quan đến sự thay đổi vật liệu và mật độ, bao gồm:
Lỗ rỗng (Voids) và Độ xốp (Porosity).
Vết nứt (Cracks).
Tách lớp (Delamination).
Đặc biệt: Kính hiển vi âm học đã chứng minh là phương pháp không phá hủy tối ưu để xác định các lớp tách lớp không khí siêu mỏng (ultrathin air delamination) trong các hệ thống nhiều lớp, nhạy cảm với các đặc điểm không khí có độ dày dưới micromet (sub-micrometric).
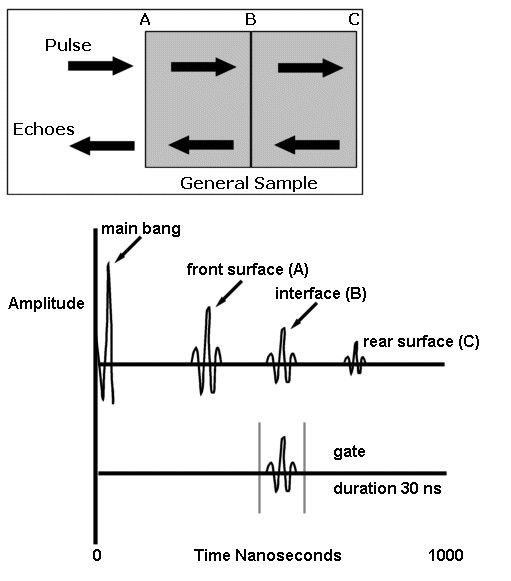
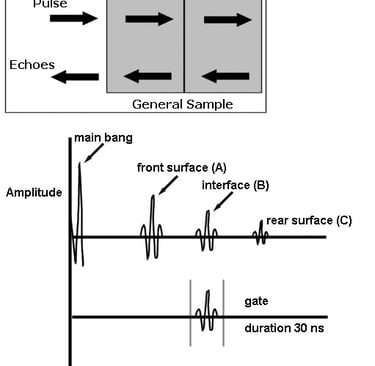
C-SAM Phát Hiện Được Những Lỗi Nào?
Kỹ thuật này cực kỳ hiệu quả trong việc phát hiện các khuyết tật ẩn trong nhiều loại linh kiện:
IC Đóng Gói Nhựa (Plastic encapsulated IC).
Hệ thống Flip Chip (CGA, FCBGA, PBGA, FPBGA...).
Wafer Đã Gắn Kết (Bonded Wafers).
Bảng Mạch In (Printed Circuit Boards - PCB).
Tụ Điện (Capacitors).
MEMS.
Các Lỗi Phổ Biến C-SAM Có Thể Phát Hiện:
Lỗi Gắn Kết Chung:
Các lớp không được gắn kết (ví dụ: wafer).
Die bị nghiêng hoặc cong vênh (Die tilt or cupping).
Tách lớp giữa các lớp laminate (Interlaminate disbonding).
Keo gắn die bị rỗ hoặc không đủ (Porous or insufficient die attach).
Nứt die (Die cracks).
Lỗ rỗng trong hợp chất đúc (Molding compound voids).
Nứt vỏ chip (Chip package cracks).
Tách lớp bên trong đế mạch (Delamination within the substrate).
Lỗi Cụ Thể Trên BGA:
Khuyết tật trong trụ đồng (Cu pillars), bi hàn (solder balls) và TSVs.
Vật liệu đệm (filler) hoặc keo gắn die quá cao.
Mặt nạ hàn (solder mask) hoặc "lead finger" bị bong ra.
Nứt vỏ BGA (BGA package cracks).
Lỗi Cụ Thể Trên Mạch Tích Hợp (IC):
Nứt vỏ IC (ví dụ: vết nứt "popcorn").
Tách lớp Lead frame (Lead frame delamination).
Lỗi Cụ Thể Trên Module Lai (Hybrid) và Đa Chip (MCM):
Tính toàn vẹn của liên kết hàn tản nhiệt (Heat sink solder bond integrity).
Chất lượng liên kết hàn nắp (Lid seal bond quality).
Vật liệu hàn không đủ (Insufficient solder material).
Hàn chảy lại quá mức (Excessive solder reflow).




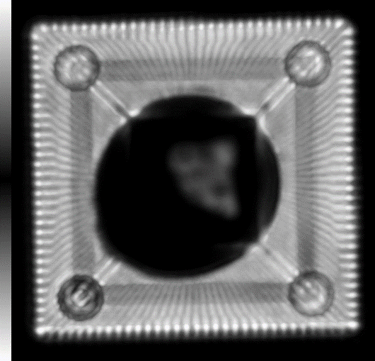

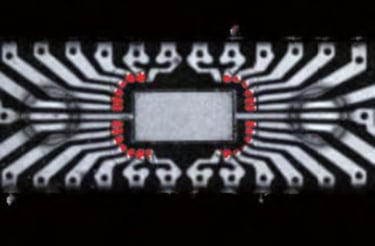
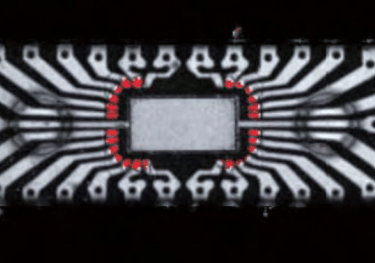
Tại Sao Chọn Kiểm Tra C-SAM?
Không Phá Hủy: Kiểm tra linh kiện mà không gây hư hại.
Độ Nhạy Cao: Đặc biệt hiệu quả với các lỗi tách lớp dạng khí siêu mỏng mà X-ray có thể bỏ qua.
Phát Hiện Sớm: Giúp xác định các vấn đề tiềm ẩn trước khi chúng gây ra hỏng hóc nghiêm trọng.
Tuân Thủ Tiêu Chuẩn: Đáp ứng yêu cầu kiểm tra của nhiều tiêu chuẩn chất lượng quan trọng.
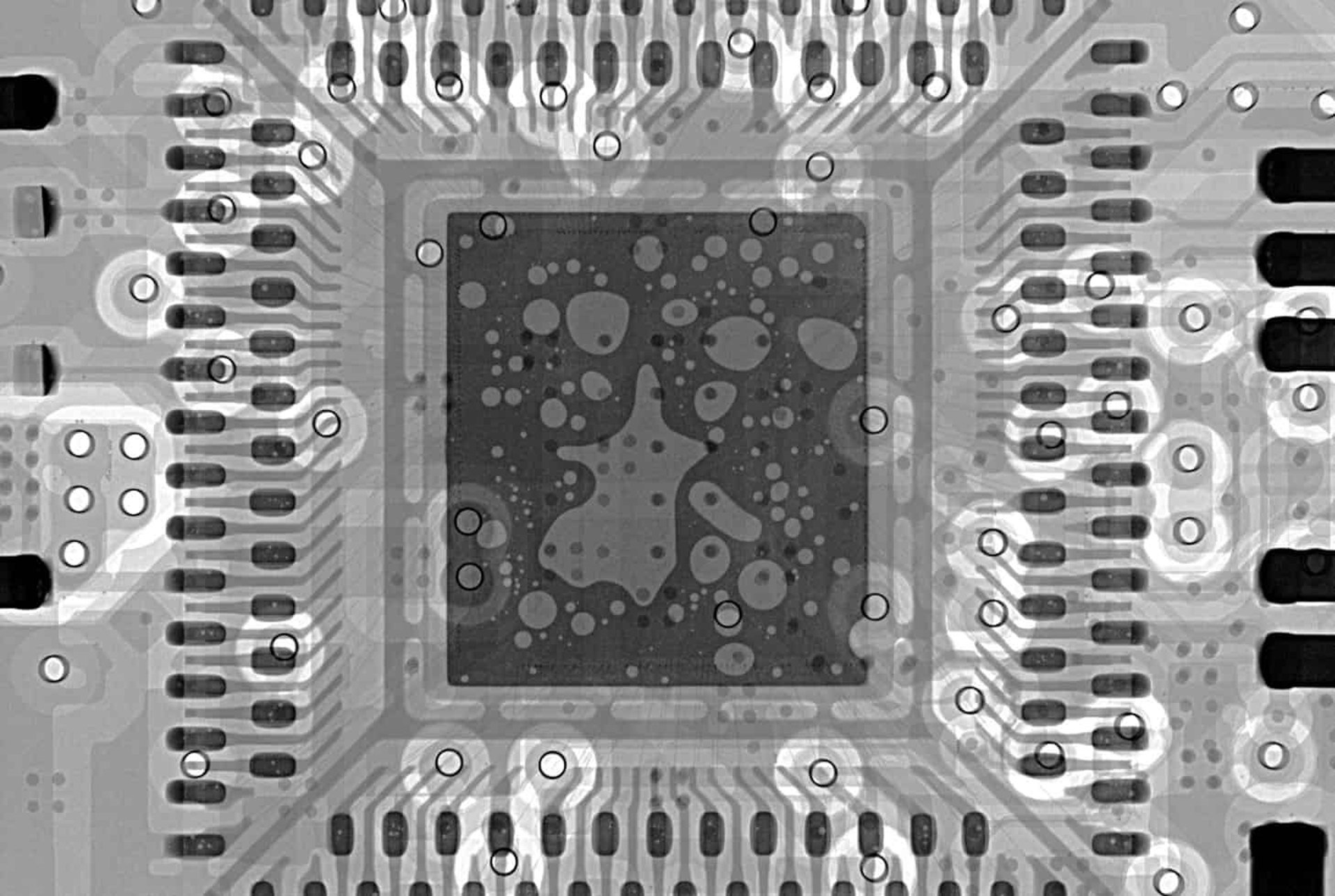
Hãy liên hệ với đội ngũ chuyên gia của chúng tôi để nhận được sự tư vấn
miễn phí và chuyên nghiệp
hoặc
Bạn quan tâm đến sản phẩm?
Cần báo giá sản phẩm hoặc dịch vụ?
© Copyright - All Rights Reserved
NudgeInsepct
Liên hệ: Hồ Lê Long Thiên (Mr.)
+84 (0) 839 54 9178 info@nudgeinspect.com
VP HCM: Tòa nhà Saigon Paragon, 3 Nguyễn Lương Bằng, Tân Mỹ, Quận 7, Hồ Chí Minh


